![]()
1. подготовка поверхности (промывка и сушка)
3. Фотолитография. Фоторезисты. Классификация по типам используемого излучения: оптическая, ультрафиолетовая, рентгеновская, электронно-лучевая литографии. Классификация по типам оптических схем: проекционная, контактная.
Литография или микролитография, нанолитография предназначена для создания топологического рисунка на поверхности пластины. Фотолитография - процесс избирательного травления поверхностного слоя с использованием защитной фотомаски. В основе фотолитографии лежит использование материалов, которые называются фоторезистами. Базовый литографический процесс представлен на рис. 1 и включает в себя, по крайней мере, 10 ступеней.
![]()
1. подготовка поверхности (промывка и сушка)
![]()
2. нанесение резиста (Центрифугированием либо аэрозольным напылением)

3. сушка (удаление растворителя и перевод резиста в твердую растворимую фазу)

4. совмещение фотошаблона и экспонирование (положительный резист под действием света переходит в нерастворимую фазу)
![]()
5. проявление резиста (промывка в растворителе, удаляющем неэкспонированный резист)

6. стабилизирующий отжиг (удаление остатков растворителя)
![]()
7. контроль и исправление дефектов
![]()
8. травление (непосредственный перенос рисунка маски на поверхность полупроводниковой структуры)
![]()
![]()
9. удаление фоторезита
10. финишный контроль
Фоторезисты.
Фоторезист — полимерный светочувствительный материал. Различают фоторезиты негативные и позитивные.
Негативные резисты активируюется при поглощении энергии в результате облучения. При проявлении пленка негативного резиста разбухает, а его неэкспонированные области с низким молекулярным весом растворяется в проявителе. Этот эффект уменьшает разрешающую способность негативных резистов. Как правило, минимальный разрешаемый размер элемента в три раза больше толщины пленки негативного резиста.
Позитивные резисты, поглощая энергию облучения, становится растворимым в водной среде. Различие в растворимости экспонированных и неэкспонированных участков резиста приводит к проявлению изображения в позитивном резисте. В отличие от негативного резиста проявитель не пропитывает всю пленку и она не набухает. В результате этого разрешающая способность позитивных резистов выше, чем негативных.

Сравнение резистов. Негативные резисты, обладая меньшей разрешающей способностью по сравнению с позитивным, имеют более высокую чувствительность (рис. 3) и их использование позволяет экспонировать большее количество пластин в час. Позитивные резисты, хотя и обладают более высокой разрешающей способностью, проявляются значительно медленнее, что приводит к уменьшению производительности и увеличению стоимости ИС. Следовательно, при определении типа используемого резиста необходимо делать выбор между разрешением и производительностью.
Классификация по типам используемого излучения
В зависимости от длины волны используемого излучения применяют следующие методы литографии:
- оптическая фотолитографию (длина волны актиничного ультрафиолетового излучения λ = 250 : 440 нм);
- Литография с экстремальным ультрафиолетом λ = 11 - 14 нм
- рентгенолитографию (длина волны рентгеновского излучения λ = 0.5 : 2 нм);
- электронолитографию (поток электронов, имеющих энергию 10 – 100 КэВ или длину волны λ = 0.05 нм);
Оптическая литография
Основными методами оптического экспонирования являются контактный, бесконтактный и проекционный.
_________________________________________________________________
Контактная печать. При контактной печати (рис. 4) пластина кремния, покрытая резистом, находится в непосредственном физическом контакте со стеклянным фотошаблоном. Пластина установлена на вакуумном держателе, который поднимает ее до тех пор, пока пластина и шаблон не придут в соприкосновение друг с другом. Прикладываемое при этом усилие составляет несколько килограммов. Для того чтобы провести совмещение топологического рисунка фотошаблона с предыдущим, вытравленным в кремнии топологическим рисунком, шаблон и пластину разводят на 25 мкм, а пару объективов с сильным увеличением помещают сзади шаблона для одновременного наблюдения рисунков шаблона и пластины из двух точек. Объективы принадлежат микроскопу с разведенным полем зрения, так что правый глаз видит точку на правой стороне шаблона и пластины, а левый - точку слева. Шаблон и пластину совмещают механическим перемещением и вращением вакуумного держателя до совпадения топологических рисунков шаблона и пластины.
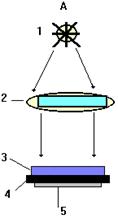
Рис. 4. Контактная печать: 1- источник света 2- оптическая система 3- шаблон 4- фоторезист 5- кремниевая пластина
В этом положении пластина приводится в соприкосновение с шаблоном и проводится еще одна проверка на точность совмещения. При экспонировании микроскоп автоматически отводится и коллимированный луч ультрафиолетового (УФ) облучения освещает весь шаблон в течение определенного времени экспонирования. Интенсивность экспонирования на поверхность пластины, умноженная на время экспонирования, дает энергию экспонирования или дозу облучения, получаемого резистом.
Разрешение при контактной литографии. Вследствие тесного контакта между резистом и шаблоном при контактной печати достигаются очень высокие значения разрешения. В пленке позитивного резиста толщиной 0,5 мкм достаточно легко можно воспроизвести элементы схемы размером 1 мкм.
Проблемы, возникающие при контактной печати, связаны с наличием загрязнений на поверхности кремниевой пластины. Кремниевая пылинка на пластине может привести к повреждению поверхности шаблона в момент его соприкосновения с пластиной. Поврежденный участок шаблона затем воспроизводится как дефектный топологический рисунок на всех других пластинах, при экспонировании которых использован этот шаблон. Каждая пластина добавляет свои собственные повреждения поверхности шаблона.
Если при изготовлении ИС не обеспечивается необходимая чистота процесса и окружающей среды, то лишь несколько кристаллов ИС не будут иметь дефектов. Для обеспечения высокого выхода годных кристаллов СБИС плотность дефектов (число дефектов на 1 см2) должна быть меньше 1 для каждого процесса литографического переноса.
Метод бесконтактного экспонирования (рис. 5) схож с методом контактной печати, за исключением того, что во время экспонирования между пластиной и шаблоном поддерживается небольшой зазор шириной 10-25 мкм. Этот зазор уменьшает (но не устраняет) возможность повреждения поверхности шаблона.
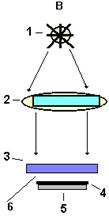
Рис. 5. Бесконтактная печать: 1- источник света; 2- оптическая система; 3- шаблон; 4- фоторезист; 5- кремниевая пластина; 6-зазор
При отсутствии физического контакта между шаблоном и пластиной перенос изображения осуществляется в дифракционной области Френеля, разрешение в которой пропорционально квадратному корню из произведения l*g, гдеl - длина волны экспонирующего излучения, g - ширина зазора между шаблоном и пластиной. При бесконтактной печати величина разрешения составляет 2-4 мкм.
Третий метод экспонирования - проекционная печать (рис. 6) позволяет полностью исключить повреждения поверхности шаблона. Изображение топологического рисунка шаблона проецируется на покрытую резистом пластинку, которая расположена на расстоянии нескольких сантиметров от шаблона. Для достижения высокого разрешения отображается только небольшая часть рисунка шаблона. Это небольшая отражаемая область сканируется или перемещается по поверхности пластины. В сканирующих проекционных устройствах печати шаблон и пластина синхронно перемещаются. С помощью этого метода достигается разрешение порядка 1,5 мкм ширины линий и расстояния между ними.
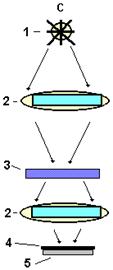
Рис. 6. Проекционная печать: 1- источник света, 2- оптическая система, 3- шаблон, 4- фоторезист, 5- кремниевая пластина
Проекционные устройства печати, в которых изображение на шаблоне перемещается над поверхностью пластины, называют системами с непосредственным перемещением по пластине или фотоштампами. При использовании этих устройств печати шаблон содержит топологию одного кристалла большого размера или нескольких кристаллов малых размеров, которые увеличены до десяти раз. Изображение этой топологии или структуры уменьшается и проецируется на поверхность пластины. После экспонирования одного элемента кристалла пластина сдвигается или перемещается на столике с интерферометрическим управлением по осям XY к следующему элементу одного кристалла, и процесс повторяется. С помощью уменьшающих проекционных фотоштампов можно получить разрешение ~1 мкм.
В большинстве современных проекционных систем печати оптические элементы являются настолько совершенными, что их характеристики точности отображения ограничены дифракционными эффектами, а не аберрацией линз. Эти устройства печати называют системами с дифракционным ограничением.
Рентгеновская литография
Общее описание рентгеновской литографии
Рентгеновская литография является разновидностью оптической бесконтактной печати, в которой длина волны экспонирующего облучения лежит в диапазоне 0.4 - 5 нм. Несмотря на то, что при рентгеновской литографии используется бесконтактная экспонирующая система, проявление дифракционных эффектов уменьшено за счет малой длины волны рентгеновского излучения.
Основная причина разработки метода рентгеновской литографии заключалась в возможности получения высокого разрешения и в то же время высокой производительности оборудования. Кроме того, за счет малой величины энергии мягкого рентгеновского излучения уменьшается проявление эффектов рассеяния в резистах и подложке, следовательно, нет необходимости в коррекции эффектов близости.
Поскольку рентгеновские лучи практически не поглощаются загрязнениями, состоящими из компонентов с малым атомным номером, то наличие загрязнений на шаблоне не приводит к возникновению дефектов рисунка на резисте. Кроме того, вследствие низкого поглощения рентгеновского излучения рентгеновский резист большой толщины может быть однородно экспонирован на всю толщину, в результате чего в его объеме у окон формируются вертикальные стенки, точно повторяющие рисунок шаблона.
Так как изготовление рентгеновских оптических элементов связано с определенными трудностями, применение рентгеновской литографии ограничено теневой печатью. Разрешение, получаемое при использовании метода рентгеновской литографии, ограничено геометрическими эффектами.
Рентгеновская литография обеспечивает наилучшие условия для достижения субмикронного разрешения при высокой производительности обработки пластин. При использовании существующих резистов и рентгеновских источников пластины полностью могут быть экспонированы за 1 минуту с разрешением <0.5 мкм.
Top of Form
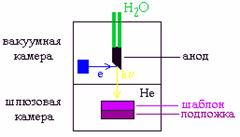
Рис. 19 Общий вид рентгеновской установки экспонирования.
Резист состоит из основного полимерного вещества и металлоорганического мономера. Излучение, падающее на резист, полимеризует мономер и основной полимер, включая в состав основного вещества металлоорганическую компоненту. После экспозиции пленка резиста высушивается в вакууме для удаления неполимеризованного мономера.
Изображение на резисте проявляется с использованием кислородной плазмы. Основным предполагаемым механизмом проявления является механизм, основанный на превращении металлоорганического мономера в окисел металла, который предохраняет остающийся резист от воздействия кислородной плазмы. Этот защитный слой далее увеличивает разницу в скорости удаления в плазме экспонированного и неэкспонированного резиста, и, таким образом, происходит проявление изображения.
Top of Form
Шаблоны для рентгеновской литографии
Рентгеновские шаблоны состоят из поглощающих рентгеновское излучение металлических пленок с нанесенным на них рисунком и тонкой мембраны, пропускающей рентгеновские лучи. Толщина поглощающего материала определяется длиной волны рентгеновского излучения, коэффициентом поглощения материала и величиной контраста, необходимой для формирования изображения на резисте. Наиболее широко применяемым в настоящее время поглощающим материалом является золото.
Литография с экстремальным ультрафиолетом
EUVL является обычной оптической
литографией, но с использованием излучения с длиной волны 11 - 14 нм и
отражательными оптикой и фотошаблонами. Источниками излучения в EUVL на первом
этапе развития подобных систем служило синхротронное излучение. Однако позже
был разработан малогабаритный источник предельного ультрафиолета, принцип
работы которого основан на использовании излучения из лазерной плазмы.
Излучение стандартного Nd:YAG лазера (1063 нм длина волны, 40 Вт мощность, 100
Гц частота, 5 нс длительность) фокусируется на импульсной газовой струе Xe
кластеров. Образующаяся лазерная плазма содержит широкую спектральную полосу
предельного ультрафиолета с ![]() ~10-25нм. Оптическая
система содержит набор зеркал между источником света и маской. Набор зеркал
между маской и подложкой с резистивным обеспечивает уменьшение размера изображения
в 4 раза. Схема установки приведена на рис. 22. Все отражательные оптические
системы должны быть асферическими с размером неоднородностей ~10 Å. Эти
зеркала представляют собой сложные пленочные покрытия: от 40 до 80 двухслойных
пленок с толщиной каждого слоя ~
~10-25нм. Оптическая
система содержит набор зеркал между источником света и маской. Набор зеркал
между маской и подложкой с резистивным обеспечивает уменьшение размера изображения
в 4 раза. Схема установки приведена на рис. 22. Все отражательные оптические
системы должны быть асферическими с размером неоднородностей ~10 Å. Эти
зеркала представляют собой сложные пленочные покрытия: от 40 до 80 двухслойных
пленок с толщиной каждого слоя ~ ![]() /4. Такое же сложное
строение имеет маска для EUV литографии, которая схематично представлена на
рис. 22.
/4. Такое же сложное
строение имеет маска для EUV литографии, которая схематично представлена на
рис. 22.

Рис. 22. Схема EUV литографии.
Подобный литографический процесс позволяет рисовать линии с
разрешением до 50 нм. Однако большой проблемой подобных систем является малое
поле зрения оптической схемы, что не позволяем экспонировать всю поверхность
кремниевой подложки. Подобные системы, как впрочем, и все другие с малой
величиной ![]() , требует применения
системы сканирования изображения маски по поверхности подложки.
, требует применения
системы сканирования изображения маски по поверхности подложки.
Если принять во внимание двадцатикратное снижение длины волны (от 248 до 20 нм), что позволит снизить значение численной апертуры и увеличить тем самым глубину фокуса и поле зрения оптических схем, то переход к EUV литографии позволил перейти 100 нм рубеж, оставаясь в рамках традиционной фотолитографии. Однако сложная зеркальная оптика и дорогостоящая технология изготовления фотошаблонов делает такой подход исключительно дорогостоящим и оставляет место для разработки литографических процессов основанных на иных физических принципах.
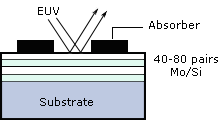
Рис. 23. Схема маски для EUV литографии.
______________________________________________________________________
Электронно-лучевая литография
Существуют две основные возможности использования электронных пучков для облучения поверхности пластины с целью нанесения рисунка. Это одновременное экспонирование всего изображения целиком и последовательное экспонирование (сканирование) отдельных участков рисунка.
Проекционные системы, как правило, имеют высокую производительность и более просты, чем сканирующие системы. Носителем информации об изображении является маска (шаблон). Изображение с шаблона передается на пластину лучом электронов.
Сканирующие системы управляются вычислительной машиной, которая задает программу перемещения сфокусированного пучка электронов для нанесения рисунка, исправляет эффекты дисторсии и расширения пучка и определяет положение пластины. Информация об изображении хранится в памяти ЭВМ.
Непосредственное нанесение рисунка с помощью ЭВМ позволяет обойтись без шаблона. Поэтому электронно-лучевые сканирующие системы могут быть использованы как для изготовления шаблонов, так и для непосредственной прорисовки на пластине. Эти установки имеют высокое пространственное расширение и точность совмещения, приближающиеся к 0,1 мкм.
Возможности применения электронно-лучевой техники в производстве микросхем весьма широки. Ограничения на ширину линий и плотность упаковки определяются не столько работой электронного пучка, сколько разрешающей способностью резиста и возможной точностью совмещения шаблона с пластиной.
Электронно-лучевая литография для изготовления шаблонов имеет явные преимущества даже в тех случаях, когда для совмещения шаблона с подложкой и экспонирования резиста применяется способ фотолитографии. ЭЛЛ обеспечивает превосходное разрешение линий оригинала, давая возможность улучшить качество шаблона. Время, которое уходит на кодирование чертежа шаблона в цифровой вид и последующее его изготовление под управлением ЭВМ, значительно меньше времени, которое требуется для процесса фотоуменьшения. Дополнительным преимуществом является то, что при изменении чертежа достаточно просто модифицировать программу ЭВМ.
Проекционная электронно-лучевая литография
________________________________________________________________
В электронно-лучевой литографии используются процессы, основанные на прямом рисовании рисунка на поверхности резиста. Подобный способ экспонирования хорош для научных целей и в производстве фотошаблонов. Низкая производительность процесса не позволяет рассчитывать на широкое внедрение этого метода в производство.
Попытки разработать эффективную систему
высокопроизводительной проекционной ЭЛЛ долгое время не давали положительного
результата по двум главным причинам. Во-первых, работа маски основана на разной
поглощающей способности отдельных участков рисунка. В результате долгого
облучения происходил ее нагрев в результате поглощения большой дозы излучения.
Это накладывало ограничение на ускоряющее напряжение проекционных электронных
литографов. Вторая причина заключалась в том, что при допустимых энергиях
электронов нельзя применять малые числовые апертуры из-за снижения глубины
фокуса и поля зрения магнитных фокусирующих систем. Далее, большие токи луча,
необходимые для повышения производительности системы, приводили к снижению
разрешающей способности метода из-за влияния пространственного заряда.
Одна из разработанных ЭЛЛ систем получила название SCALPEL. Главное ее отличие
от предыдущих заключается в использовании нового типа масок. Маска системы
SCALPEL представляет собой набор мембран, изготовленных из легких элементов, с
высокой проницаемостью для электронов. Сам рисунок образован материалом с
высокой отражательной способностью к электронам.
Электроны, проходящие через мембраны, рассеиваются на малые углы, электроны,
проходящие через область рисунка, рассеиваются на большие углы. Апертура,
расположенная в обратной фокальной плоскости полевой оптической системы
пропускает электроны, рассеянные на малые углы и не пропускает электроны,
рассеянные на большие углы, что приводит к формированию на подложке
высококонтрастного изображения. При этом в маске не происходит значительного
поглощения электронного потока, что минимизирует тепловую нестабильность маски.
Проекционные системы
Электронно-лучевая проекционная литография основана на экспонировании одиночного изображения больших размеров для получения копий шаблона с линиями субмикронной толщины. Шаблон изготавливается заранее методом сканирующей электронной литографии. Для производства электронных приборов разработаны две разновидности лучевых проекционных систем.
Система с точной передачей размеров
В системе используется фотокатод, на который нанесен необходимый рисунок в виде тонкой металлической пленки. Фотоэлектроны, вылетающие с фотокатода, ускоряются по направлению к пластине напряжением 20 кВ, приложенным между катодом и пластиной. Однородное магнитное поле фокусирует эти фотоэлектроны на пластине (аноде) с однократным увеличением изображения.
Система с уменьшением изображения
В качестве маски в такой системе используется свободно подвешенная металлическая фольга. Поток электронов, фокусированный специальной электрооптической системой, проходит через маску и формирует на пластине четкое изображение меньших размеров. Для десятикратного уменьшения размера могут быть сформированы поля диаметром 3 мм и получена ширина линий до 0,25 мкм. Схема установки приведена на рис. 24.
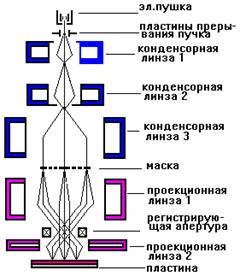
Рис. 24. Проекционная система с уменьшением изображения.
Для совмещения шаблона и образца используется режим сканирования. В этом режиме электронный луч фокусируется на шаблоне (а не на образце, как при проецировании изображения) и сканируется по нему так, что на образец попадает изображение от этого сфокусированного луча. Рассеянные от образца электроны собираются детектором положения, в результате чего вырабатывается сигнал корректировки на отклоняющие катушки, расположенные между двумя проекционными линзами. Эти системы обеспечивают очень малые искажения и высокое разрешение по сравнению с системой 1:1, где достижение соответствующих высоких параметров является проблемой.