Принципиальная схема растровый электронный микроскоп (РЭМ), разрешение, увеличение. Типы сигналов, регистрируемые в РЭМ, режим картирования.
Растровый электронный микроскоп
В сканирующей или растровой электронной микроскопии (СЭМ или РЭМ) (рис. 16а) пучок электронов с первичной энергией ~1-10кэВ фокусируется системой линз в пятно диаметром 1 – 10 нм на поверхности образца. Сфокусированный пучок сканируется по поверхности с помощью системы отклоняющих катушек синхронно с электронным пучком в видеотрубке, которая используется в качестве оптического дисплея. Оба электронных пучка управляются одним и тем же генератором сканирования, и увеличение - это просто отношение размеров дисплея и сканируемой области на поверхности образца (M=L/l, см рис. 16а). В сканирующей микроскопии используется детектирование различных сигналов, включая вторичные электроны, обратнорассеянные электроны, рентгеновское излучение и ток через образец (рис. 16б). Двумерная карта снимаемого сигнала и представляет собой изображение поверхности в сканирующем электронном микроскопе.
Основные применения сканирующей электронной микроскопии связаны с визуализацией топографии и карты распределения элементов на поверхности (рис. 18). Чтобы рассмотреть природу контраста в различных режимах СЭМ, рассмотрим структуру энергетического спектра электронов, испускаемых с поверхности, облучаемой пучком электронов с энергией Ео (см. рис. 17 и 16в). Кроме пика упруго рассеянных электронов при энергии Ео спектр содержит широкий пик вторичных электронов (ВЭ) (от 0 до около 50эВ) и область неупругих обратнорассеянных электронов (ОРЭ) (от 50эВ до Ео). Оже-пики и пики потерь на возбуждение плазмонов и межзонных переходов также попадают в диапазон ОРЭ. Подбором соответствующего детектора можно контролировать сигнал электронов соответствующего энергетического диапазона.
К СЭМ предъявляют следующие требования: 1)условия СВВ; 2) виброизоляция


Рис. 16. а – Схематическая диаграмма, иллюстрирующая принцип работы сканирующего электронного микроскопа; б – Типы сигналов, генерируемых при облучении поверхности пучком первичных электронов; в – Энергетический спектр электронов, испускаемых образцом, облучаемым первичными электронами с энергией Ер. На спектре отмечены диапазоны энергий, соответствующие вторичным электронам (ВЭ), обратнорассеянным электронам (ОРЭ) и оже-электронам (ОЭ)

ВЭ, ОРЭ, Оже-элетроны, рентгеновское излучение.
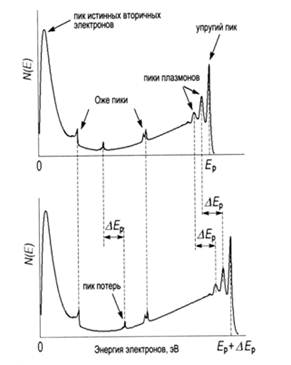
Рис. 17. Схематическое изображение энергетического спектра электронов, показывающее наличие различных групп электронов, излучаемых образцом
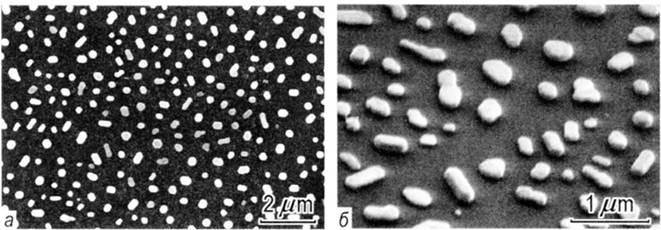
Рис. 18. СЭМ изображения пленки Au толщиной 120 Å, напыленной при комнатной температуре на поверхность TiO2 (110) и отожженной при 500° С, показывающие островки золота: а – при нормальном падении и б – под углом 45°
Основные типы сигналов, которые генерируются и детектируются в процессе работы РЭМ:
· вторичные электроны (ВЭ или режим рельефа)
· отражённые электроны (ОЭ или режим фазового контраста)
· дифракции отражённых электронов (ДОЭ)
· потери тока на образце (ПЭ или детектор поглощенных электронов)
· ток, прошедший через образец (ТЭ или детектор прошедших электронов)
· характеристическое рентгеновское излучение (РСМА или ренгеноспектральный микроанализ)
Все возможные типы детекторов, установленные на одном приборе встречаются крайне редко.
Разрешение
Пространственное разрешение сканирующего электронного микроскопа зависит от поперечного размера электронного пучка, который, в свою очередь зависит от электронно-оптической системы, фокусирующей пучок. Разрешение также ограничено размером области взаимодействия электронного зонда с образцом. Размер электронного зонда и размер области взаимодействия зонда с образцом намного больше расстояния между атомами мишени. Таким образом, разрешение сканирующего электронного микроскопа не достаточно для отображения атомных плоскостей и даже атомов, в отличие от современных просвечивающих микроскопов. Тем не менее, растровый электронный микроскоп имеет ряд преимуществ перед просвечивающим микроскопом. Это — визуализация сравнительно большой области образца, исследование массивных объектов (а не только тонких пленок), набор аналитических методов, позволяющих измерять состав и свойства изучаемого объекта.
В зависимости от конкретного прибора и параметров эксперимента, может быть получено разрешение от десятков до единиц нанометров. На 2009 год наилучшее разрешение было достигнуто на микроскопе Hitachi S-5500 и составило 0.4 нм (при напряжении 30 кВ)[10].
Как правило, наилучшее разрешение может быть получено при использовании вторичных электронов, наихудшее — в характеристическом рентгеновском излучении. Последнее связано с большим размером области возбуждения излучения, в несколько раз превышающим размер электронного зонда. При использовании режима низкого вакуума разрешение несколько ухудшается.
Подготовка объектов
Порошковые материалы наносятся малым количеством, как правило, на проводящий углеродный скотч. Массивные (не порошковые) образцы фиксируются либо на тот же скотч, либо на серебряный или углеродный клей.
Если образцы непроводящие, то на них напыляется тонкий проводящий слой для снятия заряда и экранирования падающего пучка от накопленного в объеме материала заряда. Это может быть любое проводящее вещество, однако, чаще всего используют углерод, золото или сплав золота с палладием. Первый полезен для рентгеновского микроанализа. Напыление золота или сплава на его основе позволяет получать микрофотографии с бо́льшим увеличением (чаще всего без собственной визуализации). Иногда, в случае напыления золотом, бывают заметны нанесенные частицы или дефекты в напыленном слое. Однако при напылении золотом получаются более светлые изображения, по сравнению с углеродом. Если невозможно напыление пленки на образец, то возможно снятие зарядки с образца на вводимую в камеру атмосферу (обычно азот). Для получения более четких изображений в современных микроскопах возможно локальное подведение газа.
2.4. Сравнение ПЭМ и СЭМ
Приведем сравнение в виде таблицы.
Таблица 1
|
ПЭМ |
СЭМ |
|
Лучшее разрешение вплоть до атомного 0,2 нм
|
Более простая оптика и меньшее E0 (энергия пучка электронов, обучающих образец)
|
|
В дифракционном режиме изучение кристаллографических свойств
|
Возможность исследования «толстых» образцов |
|
Низкая плотность электронного пучка – не стимулирует реакции на поверхности образца с остаточными газами |
Использование разных детекторов и анализаторов – позволяет элементное картирование образца.
|